Die Halbleiter-Leistungsgeräte der dritten Generation werden hauptsächlich auf Basis von Halbleitermaterialien wie Siliziumcarbid (SIC) und Galliumnitrid (GaN) hergestellt. Im Vergleich zu herkömmlichen Geräten auf Siliziumbasis basieren sie erhebliche Vorteile wie die Weite mit hohem Breakdown-Elektrofeld sowie eine schnelle Elektronensättigungsgeschwindigkeit. Diese Eigenschaften ermöglichen es den Halbleiter-Leistungsgeräten der dritten Generation, unter extremen Bedingungen wie hoher Temperatur, hoher Spannung und hoher Frequenz stabil zu arbeiten und eine höhere Leistungsdichte, eine geringere Verluste des Zustands und die Schaltverluste aufweisen, was die Effizienz der Energieumwandlung effektiv verbessern kann. Daher werden sie in Bereichen wie neuen Energiefahrzeugen, Photovoltaik-Stromerzeugung, 5G-Kommunikation und Schienenverkehr zu den Kernkomponenten, die die Energieumwandlung und die Entwicklung der High-End-Fertigungsindustrien vorantreiben, häufig eingesetzt.
In der Forschung und Produktion von Halbleiter-Leistungsgeräten der dritten Generation spielt die Leistung der Grenzflächenmetallverbindungsschicht (IMC) eine entscheidende Rolle für die Zuverlässigkeit und Stabilität der Geräte. EBSD -Technologie (Electron Backcatter Diffraction) als leistungsstarkes Mittel zur materiellen Mikrostrukturanalyse kann die kristallographischen Informationen, die Orientierungsverteilung und die Phasenzusammensetzung der IMC -Schicht tiefgreifend analysieren. Um hochwertige EBSD-Daten zu erhalten, ist die Probenvorbereitung eine entscheidende Voraussetzung. Folgendes sind die Metallographische Stichprobenvorbereitung Methoden für Ihre Referenz.
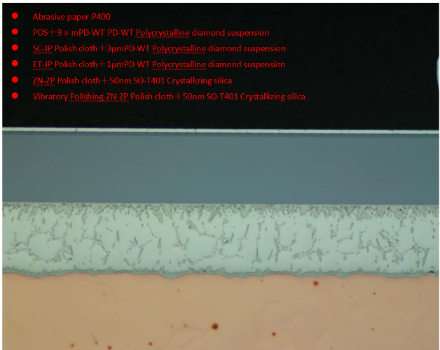
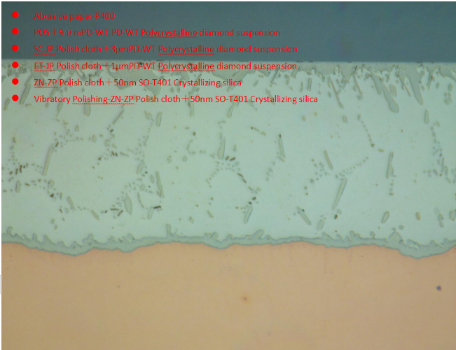
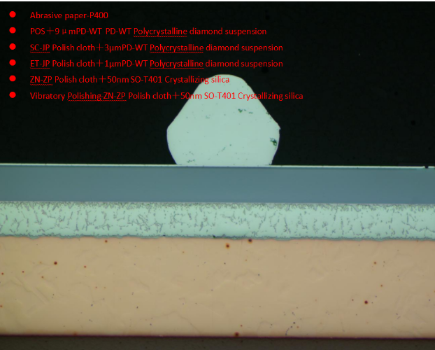

 英语
英语 西班牙语
西班牙语 德语
德语

.png?imageView2/2/w/400/format/jpg/q/75)















